Germaniumbasierte Mikroelektronik
Mit der immer weiter voranschreitenden Miniaturisierung mikroelektronischer Schaltungen wächst der Bedarf an alternativen Halbleitermaterialien, deren Ladungsträgermobilität die von Silizium deutlich übersteigt. Eines dieser Materialien ist Germanium (Ge), dessen Elektronen- und Löcherbeweglichkeit die von Si um das 2.5 fache bzw. fast 4 fache übersteigt. Bei der Prozessierung von Ge gibt u.a. folgende Herausforderungen:
(i) möglichst hohe n-Dotierung
(ii) Herstellung geeigneter Kontakte für n-dotiertes Ge-
Für beide Fälle ist die FLA sehr gut geeignet. Abb. 1 zeigt die aktive Ladungsträgerkonzentration in Phosphor-dotiertem Ge (n-Typ) nach FLA als Funktion der implantierten Phosphorkonzentration. Für die höchste Phosphorkonzentration wurde bei einer Aktivierung von 60% eine aktive Ladungsträgerkonzentration von 6·1020 cm-3 erreicht. Dieser Wert liegt über dem 3-fachen der Löslichkeitsgrenze von Phosphor in Ge und kann durch die herkömmlichen Ausheilmethoden (RTP, Ofenaus-heilung) nicht erreicht werden.
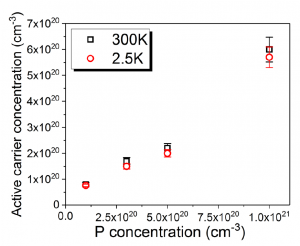
Abb. 1: Aktive Ladungsträgerkonzentration in Phosphor-dotiertem Ge nach FLA [3].
FLA kann benutzt werden, um einen guten Ohmschen Kontakt zu Ge herzustellen. Abb. 2 zeigt eine TEM Aufnahme eines NiGe Kontaktes auf einem Ge-on-Insulator-Substrat. Im vorliegenden Fall wurde das Ge mit Phophor implantiert und anschließend Ni auf der Oberfläche abgeschieden. Die nun folgende FLA diente sowohl zur
Dotandenaktivierung als auch zur Formierung des Kontaktes, was die Anzahl der Prozessschritte bei der Herstellung Ge-basierter Transistoren verringert. Die in Abb. 2 abgebildete Struktur erreichte eine Ladungs-trägerkonzentration von 1·1020 cm-3 und einen spezifischen Kontaktwiderstand von 1.2·10−6 Ω cm2.
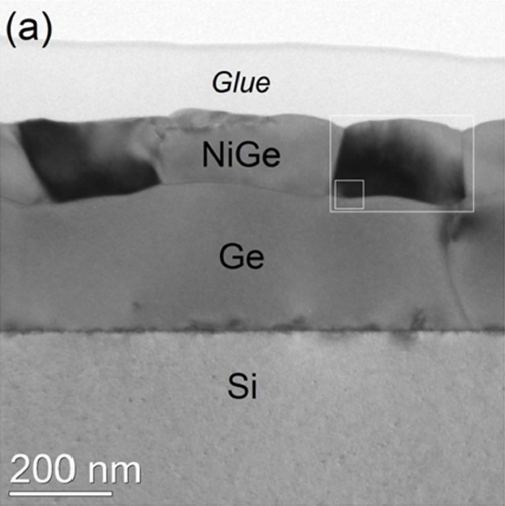

Abb. 2: TEM Aufnahme einer Phosphor-dotiertem GeOI Substrat mit NiGe-Kontakt nach FLA (a) und Detailansicht der Grenzfläche NiGe zu Ge (b). Nach [3].
FLA eignet sich auch für die Formierung von NiGe Kontakten auf dünnen Schichten von polykristallinem Ge, die z.B. im Bereich der gedruckten oder flexiblen Elektronik zum Einsatz kommen. Obwohl die Grenzfläche zwischen NiGe und Ge (Abb. 3) diffuser als im Fall von monokristallinem Ge (Abb. 2) ist,
wird für NiGe ein spezifischer elektrischer Widerstand von ca. 14 µW·cm erreicht. Dieser Wert ist vergleichbar mit Literaturwerten, die mit Rapid Thermal Processing (RTP) oder Ofenausheilung erzielt wurden.
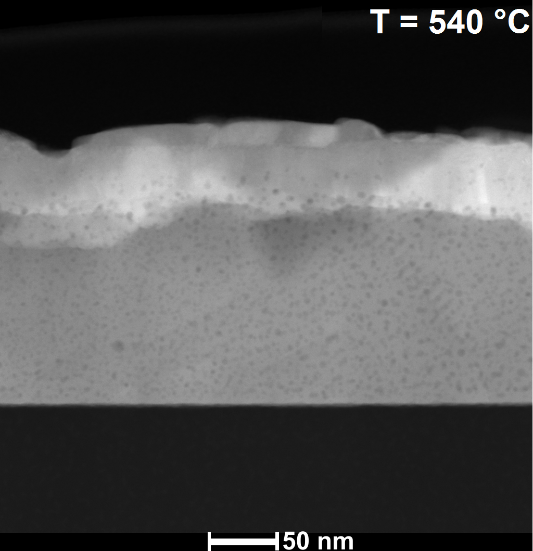
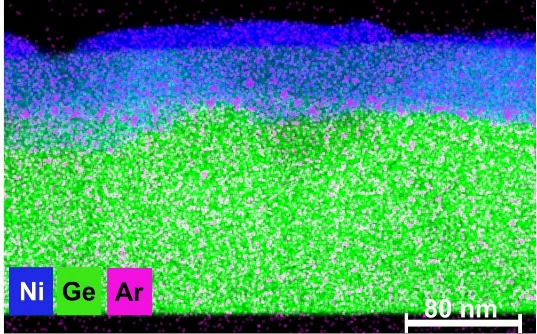
Abb. 3: TEM Aufnahme (links) und dazugehörige Elementverteilung laut EDX (rechts) für 30 nm Ni auf 160 nm Ge nach einer FLA Ausheilung.
Quellen
[1] Prucnal et al., J. Appl. Phys. 125, 245703 (2019)
[2] Prucnal et al., Semicond. Sci. Technol. 32 (2017) 115006
[3] L. Rebohle, S. Prucnal, D. Reichel: Flash Lamp Annealing – from Basics to Application, Springer (2019)
